パワーモジュール FLAP-SS
ワイドバンドギャップ半導体(SiC,GaN)向け
次世代型ケースタイプパワーモジュール汎用パッケージ
FLAP-SS
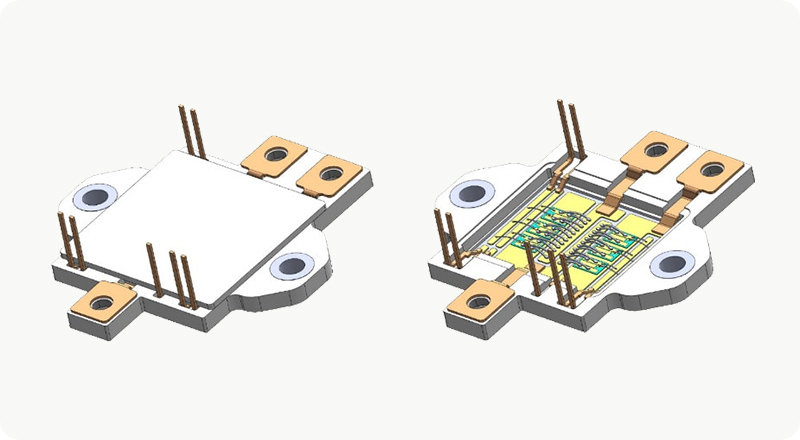
FLAPの強みの“低熱抵抗・低パッケージインダクタンス”を継承し、設計自由度を大幅に高めた新パッケージを開発しました。
FLAP-SSの特徴
封止方法の選択の自由度が向上
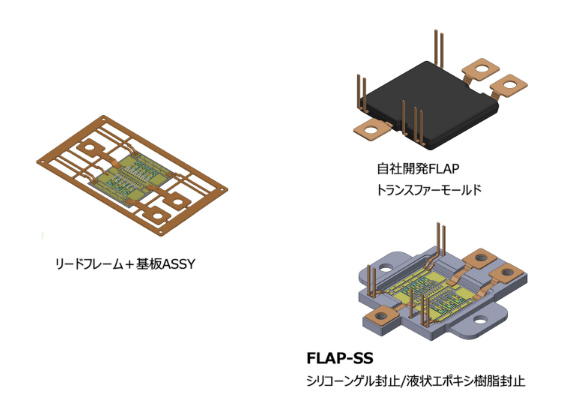
基本となるリードフレーム、回路基板を基盤に、樹脂ケースを組み合わせることでFLAP-SSとしてご利用いただけます。
自由な樹脂ケース設計が可能(2in1~「2N」in1)

自由設計可能な樹脂ケースにより、リードフレーム・回路基板の共用化が可能です。そのため、2in1、6in1など多様なパワーモジュールパッケージへ容易に展開でき、新規構造提案時の金型費用など初期コストを大幅に削減できます。
パワーデバイスパッケージ試作・評価に最適
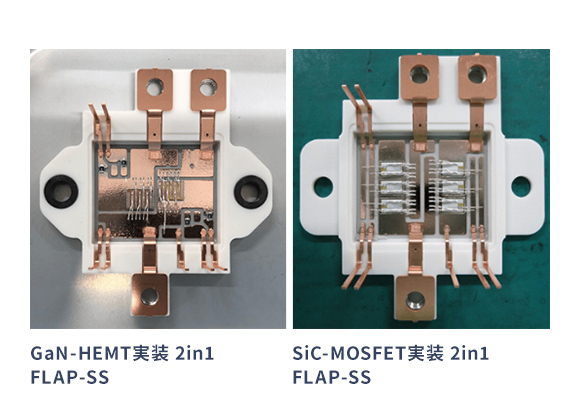
リードフレームおよび回路基板に合わせて樹脂ケースを柔軟に設計でき、幅広いパワー半導体チップの実装を実現できます。

未封止の状態でパワー半導体チップを直接観察でき、熱抵抗評価やチップ温度測定に対応可能です。
市販されているパッケージでは仕様が合わない等のお困り事がございましたら、FLAP-SSをぜひご活用ください。
御社のご希望仕様にあわせたモジュールを設計開発いたします。
納品フロー

お問い合わせ
ご相談内容をこちらからお問い合わせください。

ご回答
ヒアリング日程調整
担当のエンジニアから、初回のご回答を差し上げます。

ヒアリング
開発可能な場合は、ヒアリングにて詳細をお伺いいたします。

お見積りご提出
お見積りと納期をご提出しますので、御社内にてご検討ください。

ご発注
お見積りに沿ってご発注をいただきます。

納品
要件を満たしつつ信頼性の高い製品を納品いたします。
よくある質問
試作の依頼時に支給が必要な部材はありますか?
評価をされたいチップや部材等のみをご支給いただければ、その他の部材は弊社にて調達いたします。
依頼するにあたって資料の準備が必要ですか?
試作には様々な仕様がございますが、その中で共通事項となる仕様を記載いただくための、依頼書フォーマットを準備しております。依頼書フォーマットは、"こちら"よりご請求ください。個別の詳細仕様につきましては、任意形式での資料のご提示をお願い申し上げます。
量産を伴わない、試作のみの依頼でも対応してもらえますか?
試作のみでも全く問題ございません。設計開発品が、次の展開へ進められることを本サービスのミッションとしております。お気軽にお問い合わせください。
端子の数やケース締め付け孔の位置を変更できますか?
ご希望仕様にあわせて自由な設計変更が可能です。端子はエッチング加工、ケースは切削加工にて準備しますので、高額な金型費はかかりません。
ゲル封止をせずに納品してもらうこともできますか?
未封止の状態での納品も可能です。パワー半導体チップを直接観察できますので、熱抵抗評価やチップ温度測定にご使用いただいています。
大分デバイステクノロジー
の製品紹介
各種パッケージの開発試作・組立試作(パッケージング)も受託できます。
ケースタイプモジュール・フルモールドタイプモジュール・パワーディスクリートタイプなど、
幅広いパッケージでのご対応が可能です。