パワー半導体の試作受託
パワー半導体の開発試作から
評価・解析までを
ワンストップでサポート!
お客様の細かなニーズに対応するため、
半導体の試作受託を行っております。
大分デバイステクノロジー(ODT)で完結!

長年培った「技」で特殊な半導体組立も実現いたします。応用が必要な特注試作品もお気軽にご相談ください。
ODTのパワー半導体の試作・評価
お客様で開発半導体ウェーハ・チップを、評価用のサンプルとしてパッケージ化する試作受託サービスを展開しております。
パワーデバイスの電気的特性評価、パワーサイクル試験も可能です。
評価対象ウェーハ
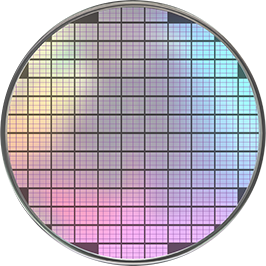


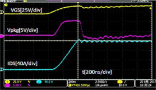
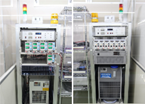
このようなご依頼も対応可能です!
ODTのパワー半導体 試作一例
セラミックパッケージ/PCB基板

DIP:デュアル・インライン・パッケージ ※Dual In-line Package

QFP:クアッド・フラット・パッケージ ※Quad Flat Package
【試作用途】
EM(エレクトロマイグレーション)評価、
長期信頼性評価
プラットフォーム

PCB:プリント基板
※Printed Circuit Board
低コスト技術

COB:チップ・オン・ボード
※Chip On Board

パワーディスクリート
FLAP-SS
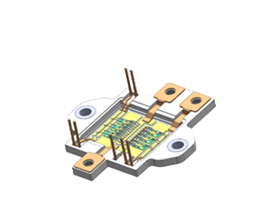
ケースタイプパワーモジュール
【試作用途】
チップ特性評価・動作試験
プラスチックパッケージ
SOP、VSSOP、 TSSOPなどプラスチックパッケージも対応可能です。
| パッケージ |
SOP ※Small Outline Package |
VSSOP ※Very Thin Shrink Small Outline Package |
TSSOP ※Thin Shrink Small Outline Package |
|||||
|---|---|---|---|---|---|---|---|---|

|

|

|

|

|

|

|
||
| 端子数 | 14pin | 16pin | 20pin | 14pin | 16pin | 20pin | 14pin | |
|
ボディサイズ(mm)
|
X | 10 | 10 | 13 | 4 | 4 | 5 | 5 |
| Y | 5.3 | 5.3 | 5.3 | 3 | 3 | 3 | 4.4 | |
| t | 1.5 | 1.5 | 1.5 | 0.8 | 0.8 | 0.8 | 1 | |
| 端子 ピッチ |
1.27 | 1.27 | 1.27 | 0.5 | 0.5 | 0.5 | 0.65 | |
| コード | SOP14-P-300-1.27 | SOP16-P-300-1.27 | SOP20-P-300-1.27 | VSSOP14-P-0030-0.50 | VSSOP14-P-0030-0.50 | VSSOP14-P-0030-0.50 | TSSOP14-P-0044-0.65A | |
| 対応 チップサイズ |
2.5×3.0mm | 3.0×5.0mm | 2.2×5.0mm | 1.4×1.8mm | 1.4×1.8mm | 1.4×2.0mm | 1.4×1.6mm | |
| リード材 | Cu,Pd-PPF | Cu,Pd-PPF | Cu,Pd-PPF | Cu,Pd-PPF | Cu,Pd-PPF | Cu,Pd-PPF | Cu,Pd-PPF | |
| 詳細 | ||||||||
今すぐ相談するお問い合わせ
セラミックパッケージの再利用納期・費用を短縮!
大分デバイステクノロジーでは、再生セラミックパッケージの活用により、試作・開発の納期を大幅に短縮いたします。新品パッケージを手配する場合、調達期間が長くなる傾向がありますが、再生品を利用することで素早く納品対応が可能です。
また、再生品の使用によりコストも削減でき、より効率的な開発を実現します。
価格は1個800円(税込価格880円)から!(※仕様により変動)
詳細な金額や納期についてはお気軽にお問い合わせください。

新品のセラミックパッケージ

使用済みのセラミックパッケージ

再生後のセラミックパッケージ
再生工程
再生パッケージ(再生PKG)として生まれ変わります。
その後、お客様からチップをご支給いただければ、
再生パッケージに搭載して納品いたします。
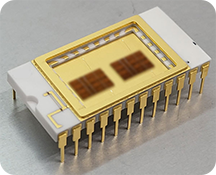
再生前
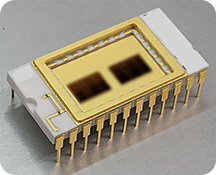
ワイヤー除去後
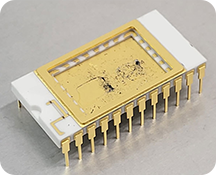
チップ除去後
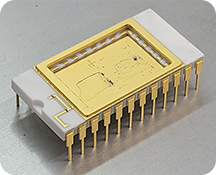
搭載チップ情報除去後
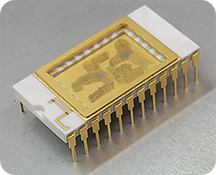
ダイボンド接着剤除去後
大分デバイステクノロジー
の製品紹介
ケースタイプモジュール・フルモールドタイプモジュール・パワーディスクリートタイプなど、
幅広いパッケージでのご対応が可能です。
製造プロセス
多様化するパッケージ形態にお応えすべく、
製造プロセスの技術向上に努めております。
※お客様からお預かりしたサンプル
| 工程 | 詳細 | プロセス | マテリアル | |
|---|---|---|---|---|
| 1 | ウェーハの裏面をパッケージデザインにあわせて薄くします。チップサイズ、もしくは指定のサイズに個片化します。 | ブレード | ウェーハ径: Max Φ12inch |
|
| 2 | チップが所定の位置からズレないよう、高精度に位置決め・固定し、後続に耐える機械強度と熱・電気特性を確保します。 | ウェーハ径 DieSize |
ウェーハ径:Max Φ12inch DieSize:□0.25~20mm |
|
| 加熱タイプ | 共昌接合:Max400℃ 半田(N2有):ディスペンス・プリフォーム |
|||
| 常温(ペースト) | ペースト材: 導電性・絶縁性 |
|||
| 3 | チップとリードフレームや基板・パッケージをボンディングワイヤーで電気的に接続し、低抵抗・高信頼でモールド等に耐える接合を形成します。 | ボール ボンディング |
Wire径:Φ15~38μm Wire材:Au,Cu,AL,Ag Wire長:0.2~9.0mm Pad Size:Min □30μm Pad Pitch:Min 40μm |
|
| ウェッジボンディング (細線タイプ) |
Wire径:Φ15~80μm Wire材:Au,Cu,AL Wire長:0.2~19.0mm Pad Size:Min □50μm Pad Pitch:Min 60μm |
|||
| ウェッジボンディング (太線タイプ) |
Wire径:Φ100~500μm Wire材:AL Wire長:2.0~40mm |
|||
| ウェッジボンディング (リボンタイプ) |
Wire幅:0.5~2.0mm Wire厚:0.1~0.3mm Wire材:AL Wire長:2.0~40mm |
|||
| 4 | チップを樹脂で一体封止し、機械強度・耐環境性・電気的保護を付与します。 | トランスファ モ―ルド |
リードフレーム: Max(45×228mm) |
|
| ポッティング | ディスペンス: 2軸ヘッド搭載 |
|||
| 5 | モールド後のストリップからダムバー/タイバーなどを切断(トリム)します。 | トリミング フォーミング |
PKG Size: □3.0~□15.7 |
|
| 6 | 電圧や電流などの定常状態におけるデバイスの動作特性を測定・解析します。 | カーブトレーサ | 電圧:Max:3,000V 電流:Max:1,000A |
|
| 7 | 所定の形態でサンプルを梱包し、出荷いたします。 | テープリール |
PKG Size: 3.0×4.0mm~ 5.3×12.8mm |
|
| チューブ | PKG Size: Max:5.3×12.8mm |
|||
| トレー | PKG Size: □12.0~□28.0 |
今すぐ相談するお問い合わせ
ODTのパワー半導体の評価・解析
電気的特性の評価(静特性・スイッチング特性)
パワーデバイスや半導体モジュールの性能を定量的に把握するための重要な試験です。

パッケージインダクタンスの検証
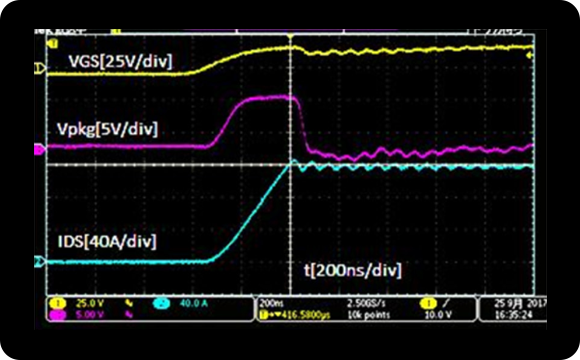
パワーデバイスの性能・信頼性を左右する重要な評価項目で、特に高速スイッチングを行うSiC(シリコンカーバイド)・GaN(ガリウムナイトライド)などの次世代パワー半導体では非常に重視されます。
パッケージインダクタンスとは、半導体チップと外部端子(リードフレームやボンディングワイヤなど)との電気的接続部分に存在する寄生インダクタンスのことです。
SAT(超音波顕微鏡)にて構造解析

SATは、超音波を使ってパッケージ内部の構造を非破壊で観察する装置です。
パッケージを切断せずに内部の接着状態や欠陥を検出できるため、信頼性評価・工程検査に広く使用されます。
パワーサイクル試験(信頼性評価)
パワーサイクル試験のみの受託も可能です。
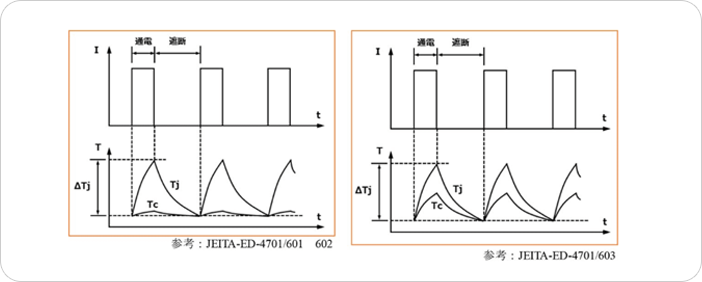
今すぐ相談するお問い合わせ
納品フロー

お問い合わせ
ご相談内容をこちらからお問い合わせください。

ご回答
ヒアリング日程調整
担当のエンジニアから、初回のご回答を差し上げます。

ヒアリング
開発可能な場合は、ヒアリングにて詳細をお伺いいたします。

お見積りご提出
お見積りと納期をご提出しますので、御社内にてご検討ください。

ご発注
お見積りに沿ってご発注をいただきます。

納品
要件を満たしつつ信頼性の高い製品を納品いたします。
よくある質問
セラミックパッケージの調達から対応してもらえますか?
調達からの対応は可能です。搭載チップのサイズやデザインによって、適合するセラミックパッケージは種々様々となっておりますため、標準品としての在庫の持ち合わせがございません。チップ搭載済のセラミックパッケージを再利用できるように処理するサービスを行っておりますので、試作評価を終えられたパッケージなどをお持ちでしたらセラミックパッケージの再利用サービスをご指名ください。
依頼するにあたって資料の準備が必要ですか?
試作には様々な仕様がございますが、その中で共通事項となる仕様を記載いただくための、依頼書フォーマットを準備しております。依頼書フォーマットは、"こちら"よりご請求ください。個別の詳細仕様につきましては、任意形式での資料のご提示をお願い申し上げます。
量産を伴わない、試作のみの依頼でも対応してもらえますか?
試作のみでも全く問題ございません。設計開発品が、次の展開へ進めることができるように本サービスのミッションとしております。お気軽にお問い合わせください。
試作仕様が固まっていませんが、相談から対応してもらえますか?
試作仕様が固まっていなくても全く問題ございません。現状の仕様やご要望事項から、加工条件などを提案させていただきます。オンラインでのお打ち合わせも可能です。お気軽にお問い合わせください。
試作時に製造現場での立ち合いは可能ですか?
立ち合いは可能です。ご要望に応じてご案内をさせていただきます。ご依頼時に立ち合い希望の旨をお伝えください。


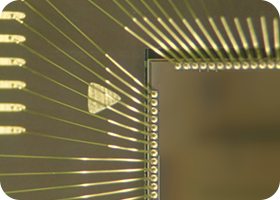
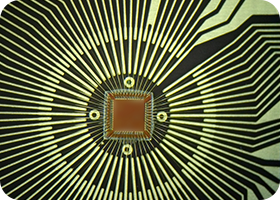
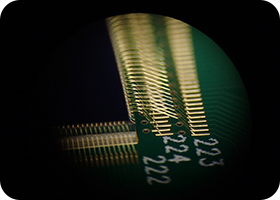

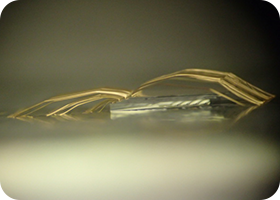
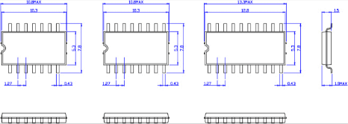
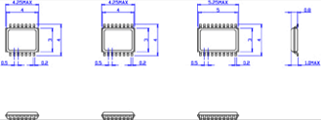
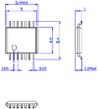

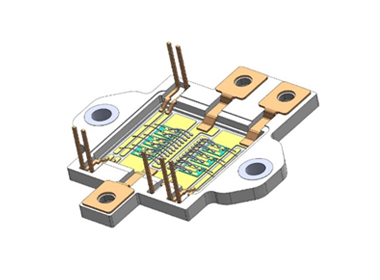




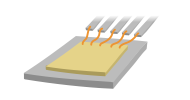
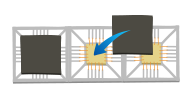
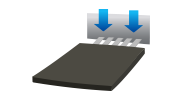










どのチップが搭載されているか、トレースが可能な状態でパッケージ化します。