パワーモジュール FLAP
ワイドバンドギャップ半導体(SiC,GaN)向け
次世代型パワーモジュール汎用パッケージFLAP

通常のパワーモジュール汎用パッケージでは、SiC(シリコンカーバイド)・GaN(ガリウムナイトライド)・Ga₂O₃(酸化ガリウム)のような、高性能デバイスでの使用には不向きでした。
自社開発のパワーモジュールパッケージ“FLAP(フラップ)”は、GaN-HEMT(ガンヘムト)の高速スイッチング性能と大電流動作を最大限に活かす設計で、体積・熱抵抗・パッケージインダクタンスなどの指標において従来品より大きく改善しました。
従来設計では難しかった課題を克服し、次世代電力変換装置の高性能化に貢献します。
※GaN-HEMT:ガンヘムト、Gallium Nitride High Electron Mobility Transistor
FLAPのコンセプト

FLAPはSiC、GaN等の性能を引き出すことをコンセプトとして開発したパワーモジュールパッケージです。
「FLAP(羽ばたく)」という意味も併せ持ち、この製品によってお取引先様の製品が世の中に羽ばたいていくようにという私たちの願いを込めています。
FLAPの特徴・試作実績
自社開発したパワーモジュールパッケージFLAPは、GaN-HEMTの性能を発揮するに最適なパワーモジュールパッケージであり、
GaN-HEMTとFLAPの組み合わせで様々な電力変換装置の性能向上が期待できます。
GaN-HEMTデバイスの課題
GaN-HEMTデバイスは高速スイッチング性能に優れている反面、寄生容量発振する可能性が高まるという問題があります。
- パワーモジュールパッケージの低インダクタンス化
- スナバ回路の追加
- 駆動条件の最適化
FLAPが技術的に解決!
- パワーモジュール内部回路パターンの最適化によるパッケージインダクタンスの低減
- FLAPパッケージ内へのスナバコンデンサ配置とゲート抵抗の配置
- GaN-HEMTを実装したFLAPに適したゲート駆動回路設計
GaN-HEMTの真価を引き出す!
FLAPパッケージ技術
GaN-HEMTにFLAPを実装させ、
高速スイッチングできることを確認できました。
650V 150A定格 GaN-HEMT実装FLAP
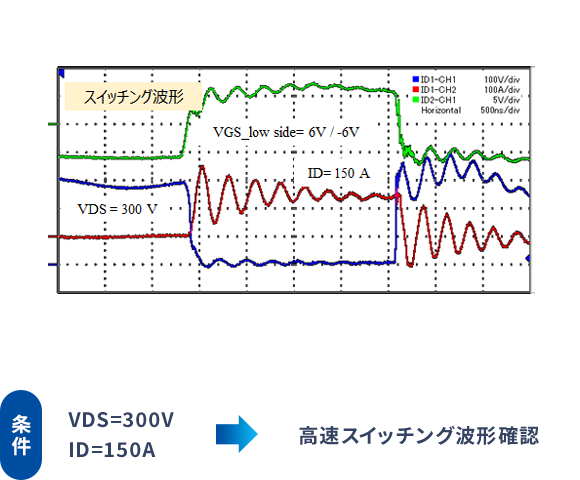
650V 300A定格 GaN-HEMT実装FLAP

| デバイス種 | 外形寸法 | 熱抵抗[℃/W] Rth_j-c | パッケージインダクタンス[nH] |
|---|---|---|---|
| 従来構造(ODT開発) | 147mm×60mm×18mm | 0.116 | 58 |
| 開発パッケージ | 71mm×40mm×5mm | 0.065 | 5.2 |
| 効果 | 体積で91%減 | 40%減 | 91%減 |
FLAPの信頼性評価
長期使用における安全性・耐久性を検証しました。
| Test Items | Test condition | result |
|---|---|---|
| TCT | Ta=-40°C⇔200°C each5min |
1,500 cycle clear |
| Power cycle test | ΔTj=100°C (Tj_min=Tc) |
60,000 cycle clear |
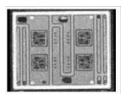
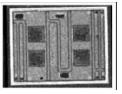
FLAPの製造プロセス
製造プロセスの技術向上に努めております。
※お客様からお預かりしたサンプル
| 工程 | 詳細 | プロセス | マテリアル | |
|---|---|---|---|---|
| 1 | チップサイズ、もしくは指定のサイズに個片化します。 | ブレード | ウェーハ径: MAX 12inch |
|
| 2 | チップが所定の位置からズレないよう、高精度に位置決め・固定し、後続に耐える機械強度と熱・電気特性を確保します。 | 搭載 | ダイサイズ: □0.25~20mm |
|
| 搭載 | ウェーハ径: MAX 8inch |
|||
| 3 | チップとリードフレームや基板・パッケージをボンディングワイヤーで電気的に接続し、低抵抗・高信頼でモールド等に耐える接合を形成します。 | ウェッジ ボンディング (太線タイプ) |
Wire径:Φ100~500μm Wire材:AL Wire長:2.0~40mm | |
| ウェッジ ボンディング (リボンタイプ) |
Wire幅:0.5~2.0mm Wire厚:0.1~0.3mm Wire材:AL Wire長:2.0~40mm |
|||
| 4 | 超音波接合を使って絶縁基板の回路パターンとリードフレームを電気的に接続し、高耐熱・高信頼な接合を形成します。 | 超音波接合 | 端子厚:t=1.0mm PKG Size:152×92mm |
|
| 5 | チップを樹脂で一体封止し、機械強度・耐環境性・電気的保護を付与します。 | ポッティング | ゲル:シリコン系 樹脂:エポキシ系 |
|
| 6 | モールド後のストリップからダムバー/タイバーなどを切断(トリム)します。 | トリミング フォーミング |
PKG Size: □3.0~□15.7 |
|
| 7 | 半導体デバイスの電圧・電流特性を測定します。 | カーブトレーサ | 電圧:Max:3,000V 電流:Max:1,000A |
|
| 8 | 所定の形態でサンプルを梱包し、出荷いたします。 | ケース | パッケージサイズによる |
納品フロー

お問い合わせ
ご相談内容をこちらからお問い合わせください。

ご回答
ヒアリング日程調整
担当のエンジニアから、初回のご回答を差し上げます。

ヒアリング
開発可能な場合は、ヒアリングにて詳細をお伺いいたします。

お見積りご提出
お見積りと納期をご提出しますので、御社内にてご検討ください。

ご発注
お見積りに沿ってご発注をいただきます。

納品
要件を満たしつつ信頼性の高い製品を納品いたします。
よくある質問
試作の依頼時に支給が必要な部材はありますか?
評価をされたいチップや部材等のみをご支給いただければ、その他の部材は弊社にて調達いたします。
依頼するにあたって資料の準備が必要ですか?
試作には様々な仕様がございますが、その中で共通事項となる仕様を記載いただくための、依頼書フォーマットを準備しております。依頼書フォーマットは、"こちら"よりご請求ください。個別の詳細仕様につきましては、任意形式での資料のご提示をお願い申し上げます。
量産を伴わない、試作のみの依頼でも対応してもらえますか?
試作のみでも全く問題ございません。設計開発品が、次の展開へ進められることを本サービスのミッションとしております。お気軽にお問い合わせください。
評価したいチップのサイズが大きいため、FLAPに搭載できるか心配です。
搭載するチップに応じてパッケージ内部の基板回路パターンを設計しますので、様々なサイズのチップを搭載できます。
端子の数や位置を変更できますか?
いいえ、できません。外部端子の仕様変更をご希望の場合は、"FLAP-SS"をご検討ください。
大分デバイステクノロジーの
製品紹介
各種パッケージの開発試作・組立試作(パッケージング)も受託できます。
ケースタイプモジュール・フルモールドタイプモジュール・パワーディスクリートタイプなど、
幅広いパッケージでのご対応が可能です。


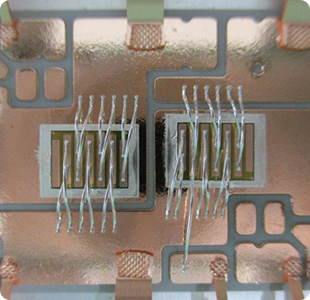 GaN実装品
GaN実装品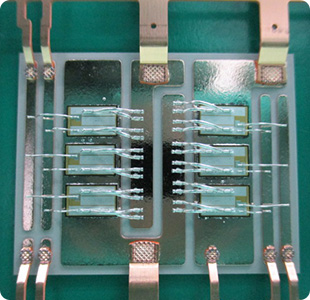 SiC実装品
SiC実装品