ORIGINAL POWER MODULE自社開発パワーモジュールSU-1/SU-2
産業用インバーターや電気自動車に最適なパワーモジュール SU-1

6 in 1 650V/400A IGBT module
OPMD0650V0400A6PK-M
弊社開発の 6in1 650V/400Aパワーモジュールは、高信頼性で電気自動車等に利用できます。
・モーター駆動
・産業用インバータ
・(EV用途は開発中)
150℃耐熱設計、3相インバーター対応、トレンチフィールドストップ。
IGBTと環流ダイオード搭載(IGBT、DiodeはMinebeaMitsumi製)。
冷却は水冷方式対応、低熱抵抗でIGBTは0.1℃/Wで高放熱。
サイズ
140mm×113mm×21mm
型番
OPMD0650V0400A6PK-M
電気的特性の特徴
・動作温度150℃
・低いオン電圧
・高速スイッチング
・高速リカバリー
機械的特性の特徴
・絶縁耐圧AC2.5kV 1分間
・低熱抵抗
・NTCサーミスタ搭載
・RoHS対応
・高耐熱ゲル封止
・蓋はエポキシ樹脂封止
用途例
・モーター駆動
・産業用インバータ
・(EV用途は開発中)

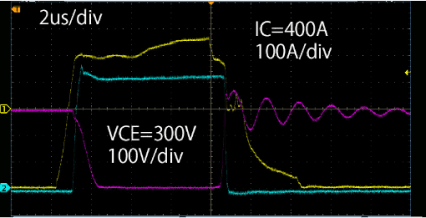
資料ダウンロード
以下のボタンより、データシートとチラシをダウンロード頂けます。
ダウンロード(zip形式)10MB汎用2in1モジュールパッケージ SU-2
また、回路構成が異なる仕様の、SU-2もあります。
高い汎用性
モーター駆動や産業用インバーターなどに特化したSU-1と比較して、SU-2は汎用性が高く、さまざまな用途に活用できます。
基板実装ありなし、どちらでも対応可能です。


パッケージ仕様(例)
| 電圧 | 電流 |
|---|---|
| 650V | 400A |
| 750V | 550A |
| 1250V | 150A |
| 〜1250V チップカスタム可 |
〜600A チップカスタム |
お客さまのご要望の使用に合わせ、搭載デバイスを選択頂けます。
また回路パターンや組み立て内容をカスタマイズできます。
ミネベアミツミ製IGBT/FRD搭載。
SiC-MOSFETも調達できます。
