PROTOTYPE SUPPORT半導体試作サポート
半導体試作サポート
開発試作から評価・解析までをワンストップでサポート

年間1,000件以上の試作実績がございます。
デバイス開発時における初期特性評価やウェーハ配線など、長期信頼性評価及び解析用として、セラミックパッケージへの組立サービスのほかに、「半導体試作サポート」を行っております。
これはお客さまの細かなニーズに対応するため、試作案件の一部工程のみを弊社にて代行するサービスです。
EM(ElectroMigration)・酸化膜経時破壊(TDDB)・TEG(Test Element Group)などのご評価にもお役立て下さい。
また、ご評価を終えたパッケージ済品からチップを取り出し、セラミックパッケージの再利用も可能です。
製造プロセス・パッケージ
多様化するパッケージ形態にお応えすべく、製造プロセスの技術向上に努めております。
以下に記載のないものや、応用が必要な特注試作品につきましてもお気軽にご相談ください。
製造プロセス
横スクロールできます
| 工程 | プロセス | マテリアル | |
|---|---|---|---|
| 裏面研削 | ブレード | ウェーハ径 | Max Φ12″ |
| ウェーハダイシング | ブレード | ウェーハ径 | Max Φ12″ |
| ダイボンディング | ウェーハ径 DieSize |
ウェーハ径 | Max Φ12″ |
| DieSize | □0.25~20mm | ||
| 加熱タイプ | 共昌接合 | Max400℃ | |
| 半田(N2有) | ディスペンス・プリフォーム | ||
| 常温(ペースト) | ペースト材 | 導電性・絶縁性 | |
| ワイヤボンディング | ボールボンディング | Wire径 | Φ15″~38μm |
| Wire材 | Au.Cu.AL.Ag | ||
| Wire長 | 0.2~9.0mm | ||
| Pad Size | Min □30μm | ||
| Pad Pitch | Min 40μm | ||
| ウェッジボンディング (細線タイプ) |
Wire径 | Φ15″~80μm | |
| Wire材 | Au.Cu.AL | ||
| Wire長 | 0.2~19.0mm | ||
| Pad Pitch | Min □50μm | ||
| Pad Pitch | Min 60μm | ||
| ウェッジボンディング (太線タイプ) |
Wire径 | Φ100″~500μm | |
| Wire材 | AL | ||
| Wire長 | 2.0~40mm | ||
| ウェッジボンディング (リボンタイプ) |
Wire幅 | 0.5~2.0mm | |
| Wire厚 | 0.1~0.3mm | ||
| Wire材 | AL | ||
| Wire長 | 2.0~40mm | ||
| 端子接合 | 超音波接合 | 端子厚 | t=1.0mm |
| PKG Size | 152×92mm | ||
| 封止 | トランスファモ―ルド | リードフレーム | Max:45×228mm |
| ポッティング | ディスペンス | 2軸ヘッド搭載 | |
| TF | トリミングフォーミング | PKG Size | □3.0~□15.7 |
| 電気テスト | カーブトレーサ | 電圧 | Max:3,000V |
| 電流 | Max:1,000A | ||
| 出荷形態 | テープリール | PKG Size | 3.0×4.0mm~5.3×12.8mm |
| チューブ | PKG Size | Max:5.3×12.8mm | |
| トレー | PKG Size | □12.0~□28.0 | |
パッケージ素材
弊社の主なパッケージ試作実績代表例をご案内いたします。
セラミックパッケージ/PCB基板の一例

DIP

PGA

QFP

QFN

PCB

COB
このほか、SOP, VSSOP, TSSOPなどプラスチックパッケージも対応可能です。
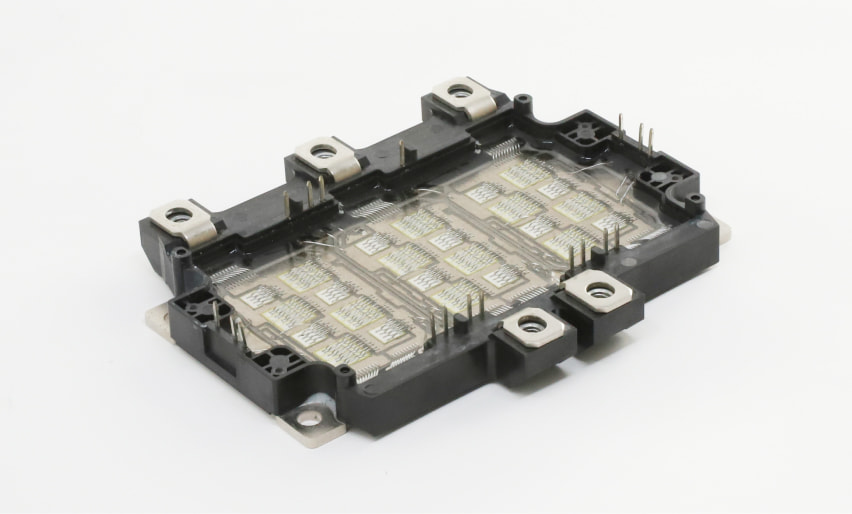
6in1モジュール(ケースタイプ パワーモジュール)

2in1モジュール(ケースタイプ パワーモジュール)


自社開発製品FLAP(フルモールドタイプ パワーモジュール)

各種TOパッケージ(パワーディスクリート)
セラミックパッケージの再生品・リサイクルで、納期と費用を同時に短縮
ODTでは、セラミックパッケージの再生品を利用することで、納期を大幅に短縮いたします。
特に最近は新品のセラミックパッケージが入手しづらい傾向にあり、その影響のため納期が長くなりがちです。
また再生品を利用することで、同時にコストも抑えられます。

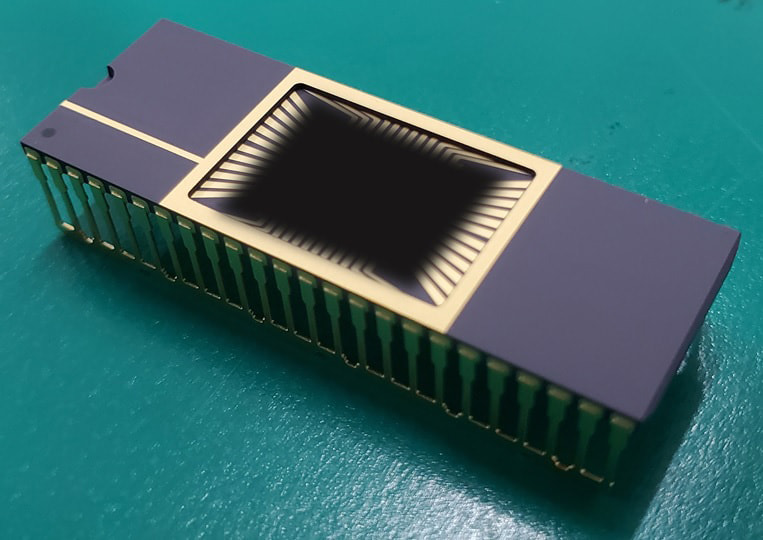

再生工程
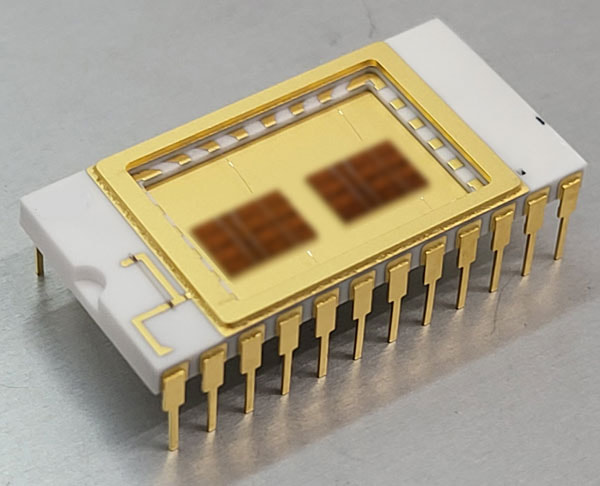
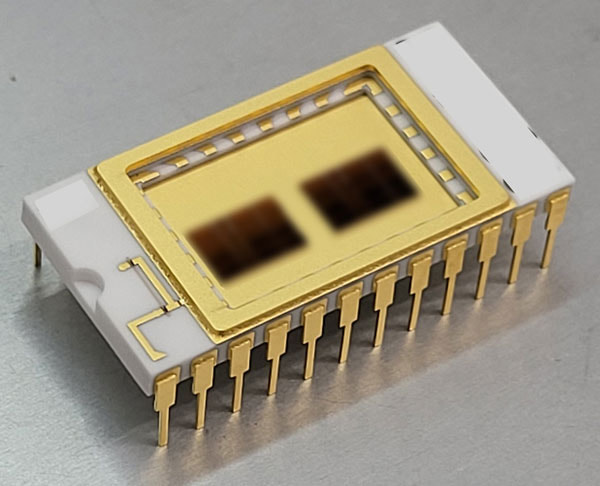
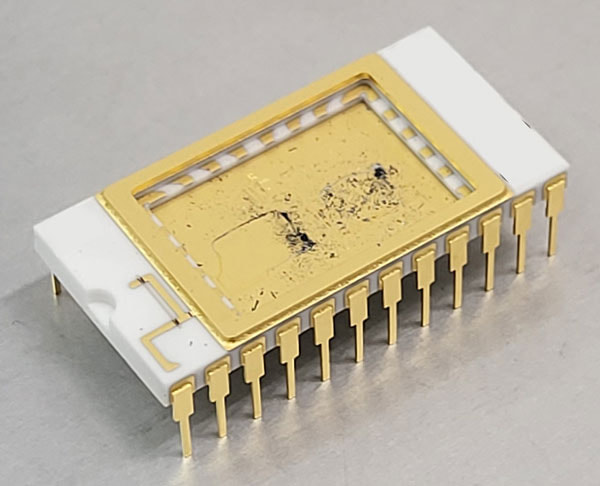
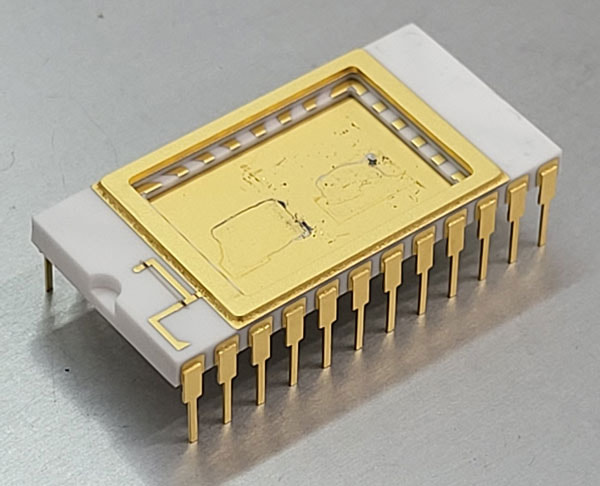
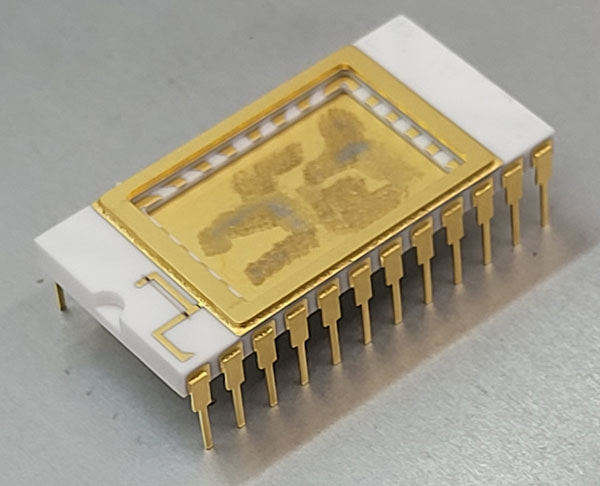
上記作業を実施して、再生パッケージ(以下、再生PKG)として生まれ変わります。
その後、お客様からチップを御支給頂ければ、再生PKGに搭載して納品致します。
試作品をお急ぎのお客様、ODTがお力になれると思います。
ぜひご相談ください。
